外延(Epitaxy)这个词来源于希腊语,意为“在上方排列”。
外延生长,是指在具有特定晶格的洁净衬底表面上沉积一层按衬底晶向生长的单晶层,新沉积的这层因为犹如衬底向外延伸出来的一样而被称为外延层。
根据外延生长的材料与衬底是否相同,可以分为同质外延和异质外延两种类型。顾名思义,同质外延指的是外延生长的材料和衬底是同一种材料的生长方式,例如在Si片上生长Si薄膜、在ZnO衬底上生长ZnO薄膜等。因为晶格匹配度高,同质外延容易得到高结晶质量的单晶薄膜,但是对于特定的材料而言,相同的高质量衬底难以获得,从而造成成本较高、难度较大。如果选用与外延材料不同的衬底来生长,就可以解决这一问题,这种方法被称为异质外延。
例如在Si衬底上生长GeSi薄膜、在蓝宝石衬底上生长ZnO薄膜等。异质外延要求衬底材料与外延层材料的晶格常数差别不大,这是为了避免生长过程中在外延层和衬底之间积存应力而导致的外延层缺陷密度过大的问题;另外,衬底材料和外延层材料的热膨胀系数也应该相近,防止出现外延层在生长结束降温过程中或者后续制备的器件在工作过程中发热而引起的外延层变形甚至脱落的现象。
二、金属有机化合物化学气相沉积技术金属有机化学气相沉积(Metal-organic Chemical Vapor Deposition ,MOCVD),也被称为金属有机气相外延(Metal-organic Vapor-Phase Epitaxy,MOVPE),是在气相外延生长(Vapor-Phase Epitaxy)基础上发展起来的一种新型气相外延生长技术。
这种技术始于1968年,由美国Rockwell公司Harold M.Manasevit等人提出,最初发现利用有机金属化合物(CH3)3Ga和AsH3在600-700℃温度下,在H2气氛的开管式反应器中生成GaAs单晶薄膜。
MOCVD主要以III族或II族元素的有机化合物和V族或VI族元素的氧化物或氢化物等作为晶体生长的原材料,以热分解反应方式在衬底上进行气相外延,生长各种III-V族或II-VI族的化合物半导体以及它们的多元固溶体的薄层单晶材料,这些生长通常是在常压或者低压(10-100 Torr)下进行的,衬底温度通常在500-1200℃。
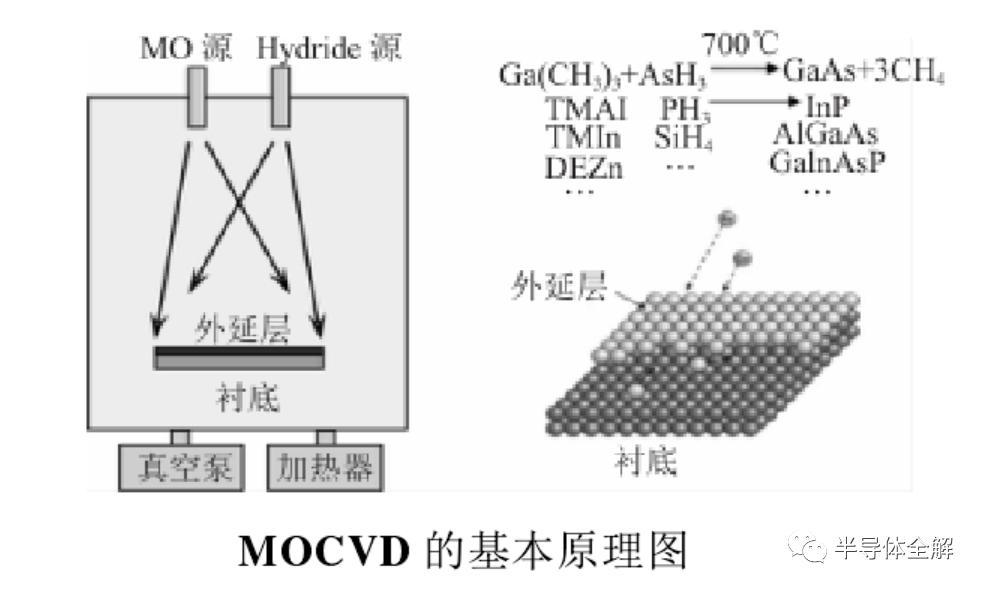
MOCVD广泛应用于包括半导体器件、光学器件、气敏元件、超导薄膜、铁电/铁磁材料、介电薄膜等多种薄膜材料的制备。实现了在蓝宝石(Al2O3)、尖晶石(MgAl2O4)和氧化铍(BeO)等材料上异质外延出GaAs,接着逐步实现了更多种Ⅲ-Ⅴ族化合物半导体的异质外延,包括AlAs、AlGaAs、InP、InAlAs、AlN、GaN和GaP等。
三、MOCVD原理及设备组成MOCVD的外延过程是一个复杂的物理化学过程。对MOCVD外延过程的理解可以从其最简单的反应化学式开始,反应涉及到挥发性有机金属化合物和气态氢化物反应前驱体的热解反应和化合反应,反应方程如下所示:
????????????+????????????→????????+????????????R代表某种形式不明的低级有机基团(甲基、乙基),A、D表示外延生成固体的组成物质,典型例子如下:
(????????3)????????+????????????3→????????????????+3????????4若是三元合金反应,有:
????(????????3)????????+(1−????)(????????3)????????+????????????3→????????????????????1−????????????+3????????4在MOCVD中,晶体生长被分为热力学过程和动力学过程,为外延生长过程提供驱动力的是热力学过程,而外延的生长速率由动力学过程决定。如下图所示,为反应过程的图解:

反应过程包括,Ⅲ族和Ⅴ族气态源中的分子扩散到加热的衬底表面,分子发生热解,有机官能团和金属原子分离,其中有完全分离的,也有部分分离的。三族金属原子沉积到衬底表面,然后V族原子附着于其上,形成新一层的薄膜,而剩余官能团和H原子脱出衬底。剩余的气体分子有未到衬底就提前结合的,也有未反应的气体,这些气体向外扩散,最后被当作尾气被抽出腔体。

在GaN的外延生长过程中,通常采用三甲基镓(TMGa)作为金属有机源,氨气(NH3)作为氢化物,氢气(H2)作为载气,其反应过程可用下述反应式进行表达:
(CH3)3Ga(g) + NH3(g) → GaN(s) + 3CH4(g)下图为MOCVD系统基本的结构图:

下图是MOCVD设备实物图片:
 MOCVD设备基本组成包括:
MOCVD设备基本组成包括:1.气体源输运系统:气体输送系统要求非常洁净,无漏气的不锈钢气路,负责传送各种气体源,包括材料组分气态源和掺杂源。目前有多种有机金属化合物应用的在MOCVD上,如三甲基镓(TMGa),三甲基铝(TMAl),三甲基铟(TMIn)等,五族气态源包括砷化氢(AsH3)、磷化氢(PH3)、锑化氢(SbH3)、氨气(NH3)、还有各类有机五族源TMAs、TMP、TMSb等。
理想的有机金属源要求易于制备和提纯,并且存在适合反应的饱和蒸汽压。有机金属源和五族无机气态源一般使用氢气、氮气的单一气体或混合气体作为载气,将其从有机金属源容器中吹送到反应室进行反应。而装载气态源是处于水浴加热的起泡器,通过质量流量计监控气态源的输出流量,而水浴加热能够控制源的饱和蒸汽压,保持恒压状态。气态源的流量能够通过载气流量进行精确控制。同时,通过控制气阀开关来实现不同气态源的开关和切换、以及反应生长的时长,以满足外延要求。另外,在气路会放置气体过滤器,以除去气体中的水汽和氧气。

2.反应室:反应室就是一个反应容器,组成结构包括石英或不锈钢腔体、承载基座、衬底加热器、压力计、温度传感器以及冷却水通道等部分。
常见的反应室是立室反应室。各种气态源从顶部进入,扩散器上方具有气体混合区域,该区域强制均匀的正常气流,气态源在其中混合,并在向下移动,通过冷过渡区,气流平行于加热基座的法线。基座迫使气流流向侧面,其速度分布取决于几何形状并受系统中热分布的影响。通过旋转基座获得更好的均匀性。
废气从反应室的底部逸出。大基座可以容纳多个晶圆。混合气体导向加热区,反应物发生上述基本的热解化合反应。另外,有多级加热器块用于引入横向温度梯度以提高均匀性。
反应腔室是 MOCVD 生长系统的核心部分,它对外延层的厚度、均匀性、质量以及杂质浓度都起着重要的作用。反应室的设计需要满足气体呈层流状态,而不至于形成湍流,从而实现反应室内气体流场和温度场的均匀分布,有利于源材料在衬底上的大面积高质量生长。反应室主要包括生长系统(喷淋头、耐高温陶瓷基座、SiC 生长台)、加热系统(电阻丝、铂铑合金热电偶)、旋转系统(步进电机)等部分。
MOCVD 的反应室分系统是一个紧耦合喷淋头系统,其结构如下图所示:

3.尾气处理系统:无论气态源是否在使用,尾气处理是一直在进行的,这是出于安全考虑所采取的措施。尾气包括未参与反应的反应气态源残余,反应生成的气体。
其中,氢化物风险最大,因为它们是高压有毒气体。烷基是第二大风险,因为尽管它们有毒且自燃,但它们是液体,通常更容易处理。还有一些气体,因为它们可能含有元素磷和砷以及这些元素的氧化物而存在危险性。
附属风险包括石英反应室(易碎)、大量爆炸性氢气、高温以及用于准备和清理生长过程的酸和溶剂。
一般处理尾气采用可进行化学中和反应的湿式过滤器处理,或送入特质的尾气燃烧/氧化装置中处理,或者多种方法组合进行尾气处理,以保证排入大气的气体无毒无害。另外,危险气体会安置于相对实验室的灰区,并存放在排气安全柜中,安全柜配有自动换缸硬件以及机械和电子流量传感、限制装置和气体检测装置。
4.控制及原位监测系统,控制系统包括工控计算机,用于编写生长程序、监控材料生长,记录生长过程产生的各种信号(传感器流量、压力、温度和报警信号),并实时对生长进行调控。
原位监测系统是在材料生长过程中,通过光学测量手段,对外延层的生长模式、生长厚度、生长速率和晶体质量等进行实时表征。
常规使用的测量手段包括反射率计、反射差分光谱仪和发射率校正高温计等。利用原位监测手段,可以提高外延质量和稳定性,保证外延工艺的可重复性。
下图是AIX-200/4型低压MOCVD系统。

关于金属有机化学气相沉积(MOCVD)的技术就介绍到这儿,码字不易,欢迎大家点赞!
参考文献:(1)基于Ⅲ-Ⅴ族化合物半导体的红外探测器研究[D] 李炫璋;(2)PEALD与MOCVD生长GaN薄膜的表面物理过程与结晶品质研究[D] 宋祎萌;(3)MgGa_2O_4基日盲紫外光电探测器的设计_制备和特性研究[D] 侯其超;(4)不同极性InGaN_GaN量子阱外延生长及其LED制备研究[D] 王阳;(5)基于异质外延的短波红外InGaAs材料生长及物性研究[D] 李雪飞;